万博ANSYS的博客
2022年11月1日
2.5D/3D-IC芯片设计中硅插入体电磁建模与仿真的挑战
2.5D/3D-IC封装技术的使用重新激活了微芯片行业,特别是在高端,如中央处理单元(cpu)、图形处理单元(gpu)和片上系统(soc),绕过了超深亚微米工艺节点进步的收益递减。但封装技术是复杂的,从芯片设计到封装和印刷电路板(PCB)开发,各个设计团队都有其影响。
这些开发团队有不同的需求和需求。芯片团队需要支持电磁、时序、功率、热效应和机械效应建模和仿真的工具。还需要捕获这些现象之间的相互作用,有效地将需求扩展到支持多物理场模拟的一组工具。该工具集将应用于每个芯片和多芯片2.5D/3D-IC设计的整体动态交互架构。
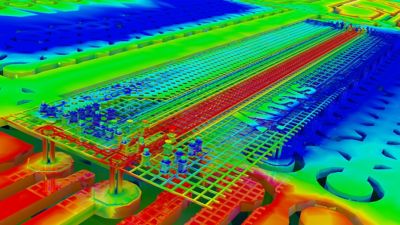
PCB和封装开发人员工具的需求非常相似,但显然更广泛。他们的建模和仿真工具需要确保封装和电路板设计的电磁、电源和信号完整性、热和机械方面,无论是单独的还是从多物理参考框架中。然而,工程师还必须考虑电路板、封装和芯片之间的多物理相互作用,作为一个完整的系统。
嵌套在所有设计和仿真需求中的是将芯片(或完整3D-IC设计中的芯片堆栈)与2.5D/3D-IC封装中的基板分离的中间层。插入器在水平面上物理分离晶片,同时为芯片堆栈的功率路由提供路径,并为封装的球栅阵列(BGA)提供信号路径。
硅中间体的优点
构成这种元素的材料越来越受欢迎的选择是硅。硅中间体使用IC制造工艺制造,尽管通常更昂贵,但可以提供独特的优势。一个是材料的热膨胀系数,它将与它所接触的模具的热膨胀系数相匹配。另一种是插入器可以支持的硅通孔(tsv)的布置。该阵列可以既密集,并与BGA封装的球间距对齐。此外,这种硅将支持用于信号和电源分配的细间距走线。总之,这些功能在原始速度和带宽方面提供了显著的性能优势。
但是,所有这些密集地封装在硅中间体中的特性,给设计2.5D/3D-IC芯片、封装和电路板的团队成员带来了额外的问题。硅介体的建模和仿真支持是一个主要的挑战-你可以看到有很多正在进行。此外,从多物理场的角度来看,硅介体是功能和能力系统中的另一个复杂组件。
使用硅中间体的2.5D3/D-IC设计人员关注的问题包括:
- 准确性:电磁模拟器能准确地捕捉我的硅中间体的所有细节吗?
- 运行时间:模拟是否会在相关的时间内(如分钟或小时)收敛于我的中间体设计参数的准确和最优解?
- 多重物理量:其他物理因素,如机械和热现象,会影响电磁(EM)模拟,是否包括在内,以提供一个完整的多物理解决方案?
- 系统仿真:我的中间体EM仿真能否与芯片、封装和PCB级别的工作相结合,并在系统级别上生成准确、及时的仿真?
- 全面的方法:工具集是否存在可以执行上述所有操作的工作流或方法?
这些以及更多的问题都是由Ansys在“万博3D-IC插入体综合多物理场分析平台的网络研讨会,于11月的第一周举行。本次网络研讨会推出了一系列关于3D-IC建模和仿真的扩展网络研讨会讨论,从芯片级扩展到完整的PCB实现。11月3日的报告概述了3D-IC设计的电源完整性、热完整性和信号完整性挑战万博Ansys Redhawk-SC电热为该习题集提供了一种综合性的多物理场仿真解决方案,并以插入体设计作为说明性应用实例。
查看按需网络研讨会现在了解3D-IC设计的所有挑战和解决方案。
看看Ansys可以万博为您做什么
看看Ansys可以万博为您做什么
今天就联系我们
谢谢你的联系!
我们在这里回答你的问题,期待与你交谈。我们Ansys销售团队的一名成员万博将很快与您联系。













